声明:本人不专门负责封装方面的工作,由于本职工作和封装有点交集,故学习了下,写了几期,分享如下,如有错误之处,还请留言指正。
一.IC封装的定义
封装给管芯(芯片)和印制电路板(PWB)之间提供电互连、机械支撑、机械和环境保护及导热通道。

二.封装的基本功能
1.电互连和线间电隔离:
(1)信号分配;
(2)电源分配。
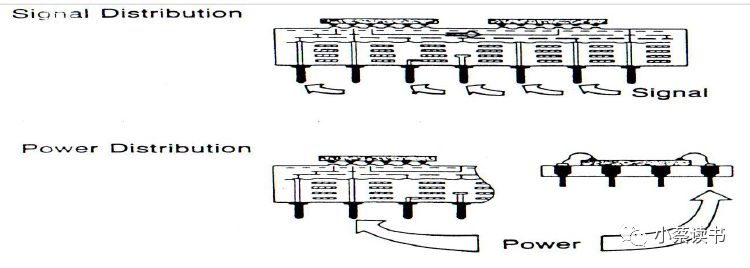
2.热耗散:使结温处于控制范围之内

3.防护:对器件的芯片和互连进行机械、电磁、化学等方面的防护

三.传统的芯片封装制造工艺
封装工艺主要完成了如下过程,从In到Out,如下图所示。
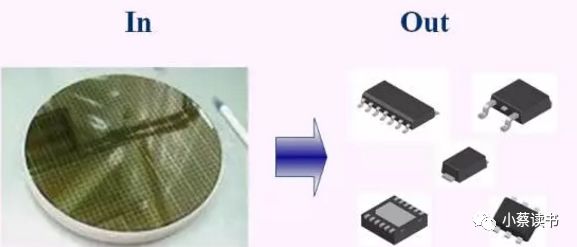
1.减薄(Back Grind)
使用研磨的方法,达到减薄的目的。第一步为粗磨,目的为减薄芯片厚度到目标值(一般研磨后的厚度为250-300um);第二步为细磨,目的为消减芯片粗磨中生成的应力破坏层(一般厚度为1-2um)。
2.贴膜(Wafer Mount)
减薄之后,要在芯片背面贴上配合划片使用的蓝膜,才可开始划片(划片过程中,蓝膜不会划开,后面分享的视频会有过程)。

3.划片(Wafer Saw)
目的:用切割刀将晶圆上的芯片切割分离成单个晶粒(Die)。
芯片依照单颗大小、需要种类等,要在蓝膜上切割成颗粒状,以便于单个取出分开。


4.贴片(Die Attach)
将芯片颗粒由划片后的蓝膜上分别取下,用胶水与支架贴合在一起,以便于下一个打线键合工艺。


5.银胶烘培(Epoxy Curing)
贴片工艺后需要用高温将银胶烤干固化,温度为175℃,时间为1小时。
6.打线键合(Wire Bond)
将芯片颗粒的金属焊接垫(bond pad)与支架,用金属引线焊接联通在一起。


7.塑封成型(Mold)
将引线键合完成的支架放入塑封模中,用塑封料把芯片、金属引线及支架包裹保护起来,同时达到塑封料外观成型的目标。

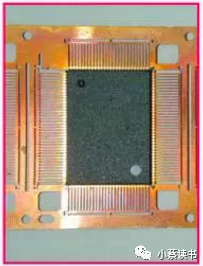
8.塑封后烘培(Post Mold Curing)
塑封料的转换固化在模具中完成80%,然后到塑封后烘培工艺中完成剩余的20%固化工作。
9.除渣及电镀(Deflash and Plating)
将塑封成型后的残渣除去后,将引线支架电镀上一层锡,将来可使用表面贴芯片的技术制作电路系统。
10.电镀后烘培(Post Plating Baking)
这一步的目的是减少及延缓锡胡须的产生,因为锡胡须会造成芯片封装后成品的引脚短路,使电路系统无法正常工作。
11.切筋整脚成型(Trim/From)
塑封完成后,要对整个支架做切筋及整脚成型的动作,使单个IC从整条支架上一个一个完整分离出来,如此整个外观才算完成。

完成封装后的样子大概是下图这样。
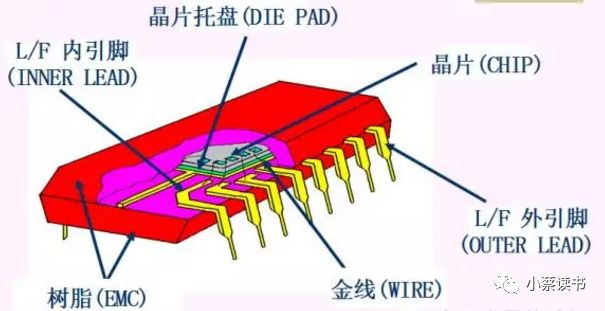

封装工艺视频
优酷上搜索“芯片封装制造全过程”(由于格式问题未能上传成功)
如果你觉得文章有用,请点个在看,如果能转发一下就更好了,谢谢!






